<del id="aymay"></del> 集成電路測試(IC測試)的目的是將合格芯片與不合格芯片區分開來,得以保證產品的品質。隨著集成電路技術不斷更新,對電路質量與可靠性的要求進一步提高,集成電路的測試方法也越來越復雜。因此,研究和發展IC測試有著重要意義。測試向量作為IC測試中不可缺少的部分,研究其生成方法也更加專業。
測試原理
IC測試是指依據被測器件(DUT)特點和功能,給DUT提供測試激勵(X),通過測量DUT輸出響應(Y)與期望輸出做比較,從而判斷DUT是否符合格。圖1所示為IC測試的基本原理模型。根據器件類型,IC測試可以分為數字電路測試、模擬電路測試和混合電路測試。數字電路測試是IC測試的基礎,除少數純模擬IC如運算放大器、電壓比較器、模擬開關等之外,現代電子系統中使用的大部分IC都包含有數字信號。
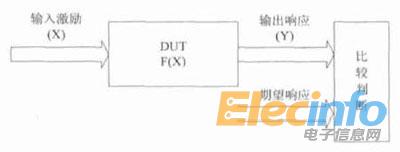
圖1 IC測試基本原理模型
數字IC測試一般有直流測試、交流測試和功能測試。
功能測試
功能測試用于驗證IC是否能完成設計所預期的工作或功能。功能測試是數字電路測試的根本,它模擬IC的實際工作狀態,輸入一系列有序或隨機組合的測試圖形,以電路規定的速率作用于被測器件,再在電路輸出端檢測輸出信號是否與預期圖形數據相符,以此判別電路功能是否正常。其關注的重點是圖形產生的速率、邊沿定時控制、輸入/輸出控制及屏蔽選擇等。
功能測試分靜態功能測試和動態功能測試。靜態功能測試一般是按真值表的方法,發現固定型(Stuckat)故障。動態功能測試則以接近電路工作頻率的速度進行測試,其目的是在接近或高于器件實際工作頻率的情況下,驗證器件的功能和性能。
功能測試一般在ATE(Automatic Test Equipment)上進行,ATE測試可以根據器件在設計階段的模擬仿真波形,提供具有復雜時序的測試激勵,并對器件的輸出進行實時的采樣、比較和判斷。


